Labor Elektroniktechnologie
Das Labor für Elektroniktechnologie ist für die Herstellung von Dickschichthybridschaltkreisen und Leiterplatten für Lehre und Forschung in Kleinserien bzw. Einzelfertigung ausgelegt. Damit wird ein wesentlicher Grundstein für die praxisnahe Ausbildung im Studiengang Elektrotechnik, Studienschwerpunkt "Industrielle Elektronik" gelegt. Um den sich ergebenden technologischen Anforderungen auch in Perspektive gerecht zu werden, werden sämtliche Arbeiten unter Reinraumbedingungen durchgeführt. Die Räume sind nach Federal Standard 209E bzw. nach VDI 2083 geplant und eingemessen worden.

| Laborleiter: | Prof. Dr.-Ing. R. Knechtel |
| Laboringenieur: | Dipl.-Ing. M. Wenig |
| Raum: | B 0001 / 0002 / 0003 / 0008 / 0010 |
| Tel: | 5326 / 5327 / 5328 / 5330 / 5311 |
Lehrveranstaltungen im Labor
- Praktikum "Träger-, Aufbau- und Verbindungstechnik"
im Bachelor-Studiengang Elektrotechnik und Informationstechnik
Ausstattung / Technische Abläufe
Lithographie

Lackbeschichter
Anlage zum Beschichten von Halbleiterwafern und anderen Substarten mit einer maximalen Größe von 8“ (Durchmesser) mit Fotolacken oder andren fotoempfindlichen oder sensorischen Materialien. Es wird eine homogene Schichtdicke im Bereiche einiger Mikrometer erzeugt.
Maskenloses Belichtungssytsem
Heidelberg Instrument MLA100, Anlage zum Belichten von Fotolacken zur Realisierung von sensorischen und elektronischen Strukturen sowie vons Schaltungsträgern. Es ist eine Strukturauflösung von 1µm mit dieser Anlage möglich, die entspricht dem aktuellen Stand der Mikrosystemtechnik. Mittels eine Mikrospiegelarrays werden die entsprechenden Schaltungsdesigns direkt vom Computer auf die Substrate belichtet. Somit entfällt die teure und kostspielige Herstellung von Glasmasken, wie sie in der industriellen Mikrofertigung eingesetzt werden.
Layouterstellung

Photoplotter
Zur Herstellung der Filme wird ein Photoplotter MIVA 1648 verwendet. Das Layout wird mit einer Xenon-Blitzlampe direkt auf einen äußerst lichtempfindlichen Film übertragen. Die Plotfläche beträgt 410 x 560 mm. Geplottet wird mit einer Auflösung von 3,13 bzw. 6,35 Mikrometern bei einer Genauigkeit von +/- 12 Mikrometern und einer Wiederholbarkeit von +/- 8 Mikrometern. Es werden die Eingabeformate Gerber, HPGL und Marconi-Quest
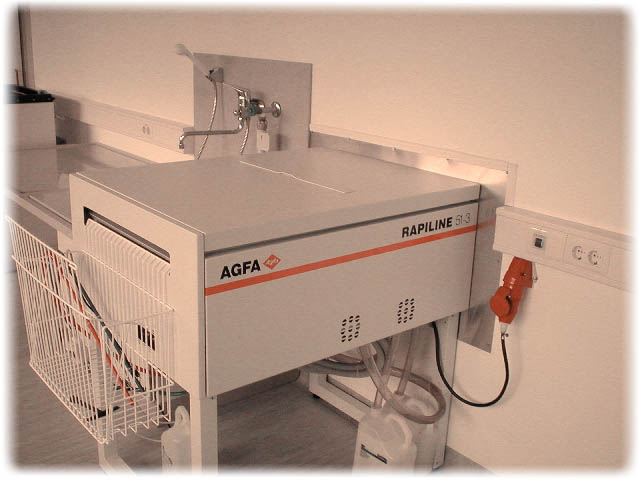
Filmentwicklungsmaschine
Nach der Belichtung wird der Film entwickelt und fixiert. Dies kann entweder manuell in Fotoschalen oder in der Filmentwicklungsmaschine erfolgen. Der Entwicklungsvorgang dauert etwa 30 Sekunden.
Siebherstellung

Belichtung
Die bespannten Siebrahmen werden mit fotoempfindlichen Material beschichtet. Nach dem Trocknen erfolgt die Belichtung mit UV-Licht durch eine 3000-W-Metall-Halogenid-Lampe. Als Kopiervorlage dient der zuvor hergestellte Film.

Ausspülen
Nach der Belichtung im Siebkopierer werden die Siebe mit Wasser ausgespült. Die Strukturbereiche, durch die die Paste gedruckt wird, werden dabei geöffnet. Warmes Wasser (35-40 Grad Celsius) erleichtert das Entwickeln.
Laser / Montage

Batchofen
Mit dem Batchofen werden die Bauelemente im Reflow Lötverfahren auf den Träger aufgelötet. Bei diesem Verfahren wird das zuvor aufgebrachte Lot aufgeschmolzen.Die Heizleistung beträgt 2 x 1,5 kW .Es können Leiterplatten bis zu einer Größe von 305 x 305 mm in Temperaturbereiche von 50 bis 299 Grad Celsius erwärmt werden. Dabei sind 199 Temperaturprofile speicherbar. Die Inspektion kann mittels einer Farb-Miniaturkamera VM1000C-NTSC und Farbmonitor erfolgen. Der Batchofen kann auch zur Trocknung der auf Keramiksubstrat gedruckten Siebdruckpasten verwendet werden.
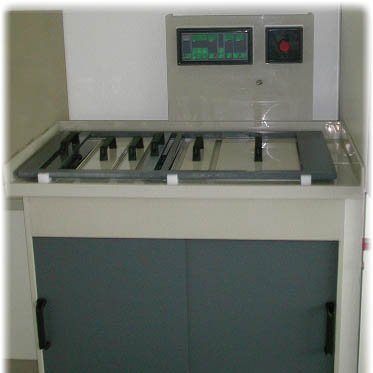
Durchkontaktierung
Die Durchkontaktieranlage LPKF Contac wurde speziell für die Herstellung von Prototypen und Kleinserien entwickelt. Sie benötigt nur 4 Bäder und kommt ohne chemische Vorverkupferung aus. Es können Leiterplatten bis zu einer Größe von 220 x 420 mm und bis zu 6 Lagen verarbeitet werden. Der Mindest-Lochdurchmesser beträgt 0,3 mm.
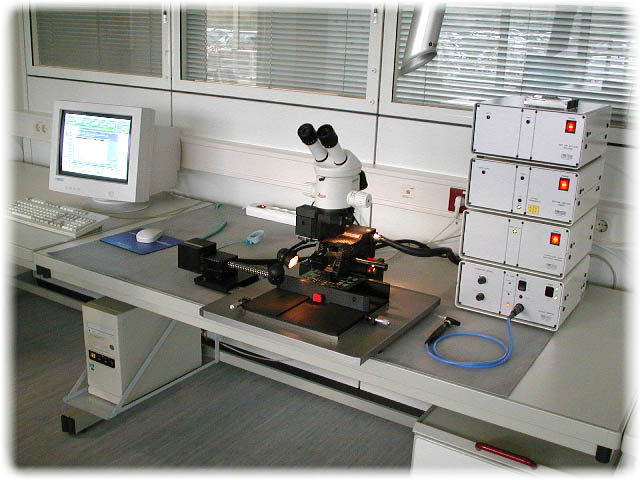
Fineplacer
Der Fineplacer wird für die genaue Positionierung von Bauelementen verwendet. Er hat eine Positioniergenauigkeit von 4 Mikrometern und dient hauptsächlich zur Flip-Chip- u. Ultra-Fine-Pitch-Montage. Über eine Optik wird eine visuelle Überlagerung von IC-Unterseite und Trägeroberseite vorgenommen. Das Comiss-Modul ist als Heißgas-Steuergerät und wird zum Löten von Fine-Pitch-Bauelementen verwendet.
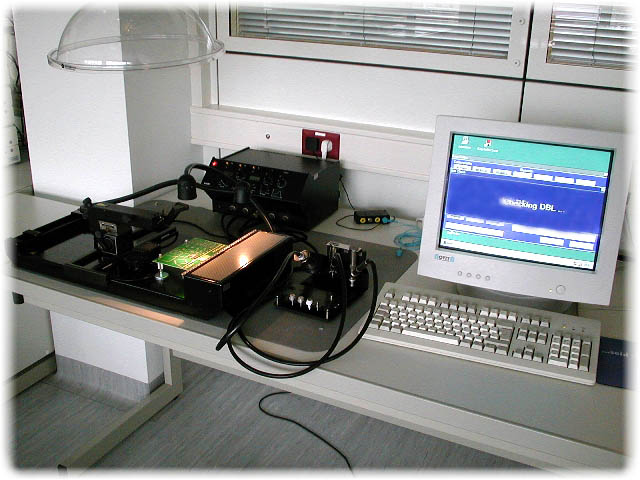
SMD-Station
Die SMD-Station ist ein Kombigerät für die Bereiche, Reparatur, Service und Kleinserienfertigung und ermöglicht das Entlöten von SMDs, das Entfernen von Altlot, Auftragen von Lotpaste und Klebstoff, und Einlöten von SMD-Bauteilen. Nahezu alle SMD-Typen können verarbeitet werden, die maximale Leiterplattengröße beträgt 500 x 320 mm.Die Steuerung erfolg über einen PC.

Dispenser
Mit dem Dispenser wird eine genau dosierte Lotpastenmenge für jedes Pad aufgetragen. Dies ist insbesondere für Fine-Pitch und BGA-Anwendungen erforderlich, da die Rastermaße moderner Bauteile hohe Genauigkeiten erfordern, die mit freihändigen Auftrag nicht mehr erreichbar sind. Die Steuerung erfolgt über einen PC. Der Dispensautomat ergänzt die SMD-Kompaktstation.
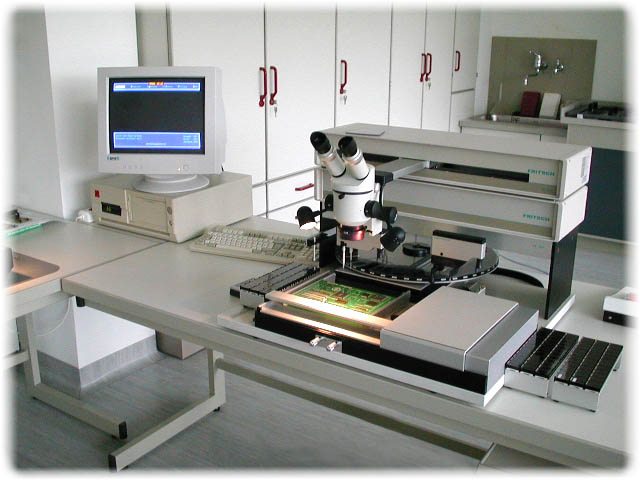
Bestückung
Das System kann sowohl SMD-Bauteile als auch Fine Pitch-Bauteile bestücken. Dazu sind 2 verschiedene Arme mit Adaptern angebracht. Für höchste Präzision gibt es eine motorische Absenkung der Fine Pitch Bauteile oder es wird mittels x-y-Mikrometerschrauben fein positioniert.
Siebdruck / Einbrand / Bonden
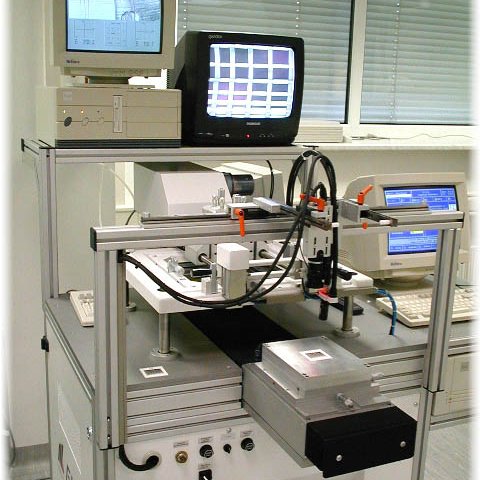
Siebdrucker
Mit dem Siebdrucker lassen sich Trägermaterialien wie Glas, Keramik, Metall, Leiterplatten oder Folien bedrucken. Auf das Sieb wird die Paste aufgetragen und gleichmäßig verteilt. Beim nachfolgenden Druckvorgang (Rakeln) wird die Paste durch die geöffneten Bereiche des Siebes auf das Substrat gedruckt. Verwendbar sind alle gängigen Leiterbahn-, Widerstands-, Lot- und Polymerpasten sowie Kleber.
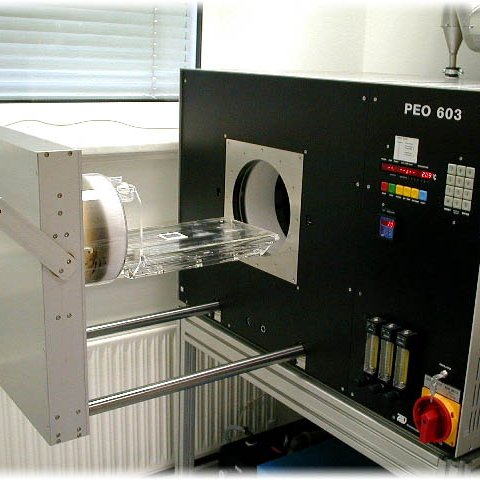
Trocknen / Sintern
Nach dem Siebdruck befinden sich in der aufgedruckten Paste noch verschiedene Lösungsmittel und andere organische Bestandteile. Um diese zu entfernen, wird ein mehrstufiger Trocken- und Einbrennvorgang durchgeführt. Zunächst werden im Trockenofen bei ca. 130 Grad Celsius die leichtflüchtigen Lösungsmittel entfernt. Daran schließt sich ein mehrstufiger Prozeß im Einbrennofen an, mit dem in mehrern Schritten zwischen 600 und 850 Grad Celsius die schädlichen Restanteile der Pasten entfernt werden und die Pasten gesintert werden. Die Temperaturabweichung beträgt hierbei maximal 2 Grad.

Bonder
Für die elektrische Verbindung von Silizium-Chips auf verschiedenen Trägermaterialien wird ein Bonder verwendet. Hierbei handelt es sich um einen Ultrasonic-Bonder. Als Verbindungsdrähte werden Gold- oder Aluminiumdrähte mit Durchmessern im Bereich von 17 bis 40 Mikrometern verwendet.
